- 搜索
电子封装与SMT 是相交还是平行
电子封装与SMT,是相交还是平行?目前,封装技术的定位已从连接、组装等一般性生产技术逐步演变为实现高度多样化电子信息设备的一个关键技术。更高密度、更小凸点、无铅工艺等都需要全新的封装技术,以适应消费电子产品市场快速变化的特性需求。而封装技术的推陈出新,也已成为半导体及电子制造技术继续发展的有力推手,并对半导体前道工艺和表面贴装(SMT)技术的改进产生着重大影响。
如果说倒装芯片凸点生成是半导体前道工艺向后道封装的延伸,那么,基于引线键合的硅片凸点生成则是封装技术向前道工艺的扩展。我们不难观察到,面向部件、系统或整机的多芯片组件(MCM)封装技术的出现,彻底改变了封装只是面向器件的概念,由于MCM技术是集PCB、混合电路、SMT及半导体技术于一身的集合体,所以我们可称之为保留器件物理原型的系统。
在整个电子行业中,新型封装技术正推动制造业发生变化,市场上出现了整合主动和被动组件、模拟和数字电路,甚至含有功率组件的封装模组,这种将传统分离功能混合起来的技术手段,正在使后端组件封装和前端装配融合变成一种趋势。新型封装技术促使组件的后端封装工序与贴装工艺前端工序逐渐整合,很有可能会引发SMT产生一次工艺革新。
可以说,元器件是SMT技术的推动力,而SMT的进步也推动着芯片封装技术不断提升。片式元件是应用最早、产量最大的表面贴装元件,自打SMT形成后,相应的IC封装则开发出了适用于SMT短引线或无引线的LCCC、PLCC、SOP等结构。四侧引脚扁平封装(QFP)实现了使用SMT在PCB或其他基板上的表面贴装,BGA解决了QFP引脚间距极限问题,CSP取代QFP则已是大势所趋,而倒装焊接的底层填料工艺现也被大量应用于CSP器件中。
随着01005元件、高密度CSP封装的广泛使用,元件的安装间距将从目前的0.15mm向0.1mm发展,这势必决定着SMT从设备到工艺都将向着满足精细化组装的应用需求发展。但SiP、MCM、3D等新型封装形式的出现,使得当今电子制造领域的生产过程中遇到的问题日益增多。由于多芯片模组等复杂封装的物理设计、尺寸或引脚输出没有一定的标准,这就导致了虽然新型封装可满足市场对新产品的上市时间和功能需求,但其技术的创新性却使SMT变得复杂并增加了相应的组装成本。
可以预见,随着无源器件以及IC等全部埋置在基板内部的3D封装最终实现,引线键合、CSP超声焊接、DCA、PoP(堆叠装配技术)等也将进入板级组装工艺范围。所以,SMT如果不能快速适应新的封装技术则将难以持续发展。
为了迎合后端组件封装和前端装配的融合趋势,封装业者及其设备供应商与SMT制造商和设备商之间只有密切合作,才能真正满足消费电子时代的市场需求。由工艺决定设备及配置,这就是中国电子制造业未来的发展趋势。中国的半导体封装正处于高速发展阶段,电子组装业的扩张已有放缓之势。在此背景下,加强封装、组装产业间的技术交流与协作,将对推动中国半导体封装、电子组装业持续高速发展起到积极的作用。但令人遗憾的是,目前国内将封装与电子组装有机衔接的交流平台却较少。
2007年首次将封装与电子组装结合起来进行交流的“CHINA SMT FORUM”引起了业内的关注。据悉,这个由德国美沙国际展览公司(BMC AG)主办的年度大会今年还将增设展览内容,PACKAGING/SMT/ASSEMBLY展会将突出展示先进的电子封装和组装技术,通过将电子封装技术和组装工艺设备进行整合,为电子封装、组装及相关领域的专业人士搭建一个有关各方相互间对上话的技术交流平台。
BMC AG中国称,2008中国国际电子封装和组装技术设备展暨大会,得到了德国机械设备制造业联合会(VDMA)的主动支持。同时,国内主要封装设备、封装厂、SMT设备商、电子制造商等均表达出极强的参与愿望。中国已是全球电子制造中心,在不久的将来也势必会成为全球封装业的重镇。所以,在解决好后端组件封装和前端装配融合的问题上,中国比世界上任何一个国家和地区都显得迫切。
(部分内容源自网络,编辑:xiao)
秦泰盛
2013.7.8
相关阅读




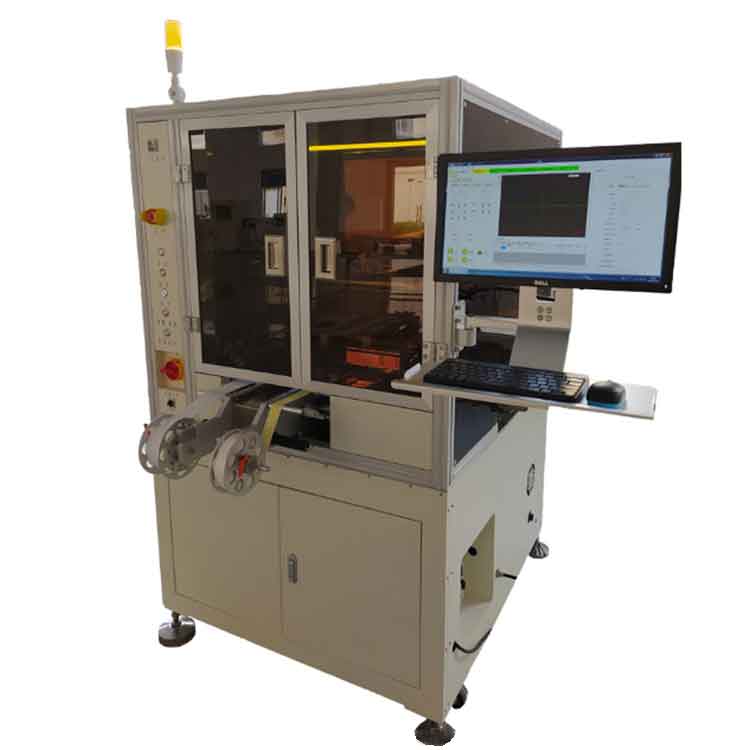
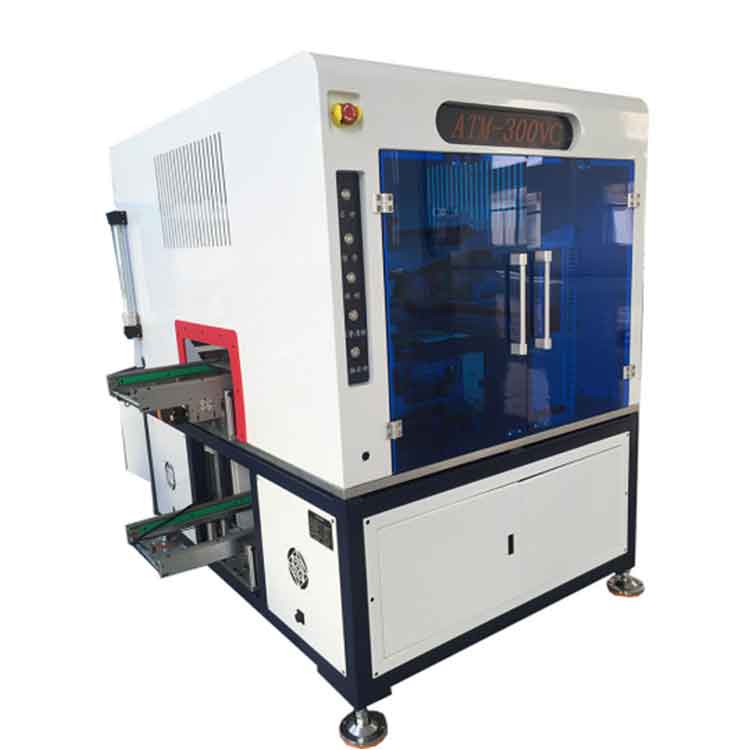
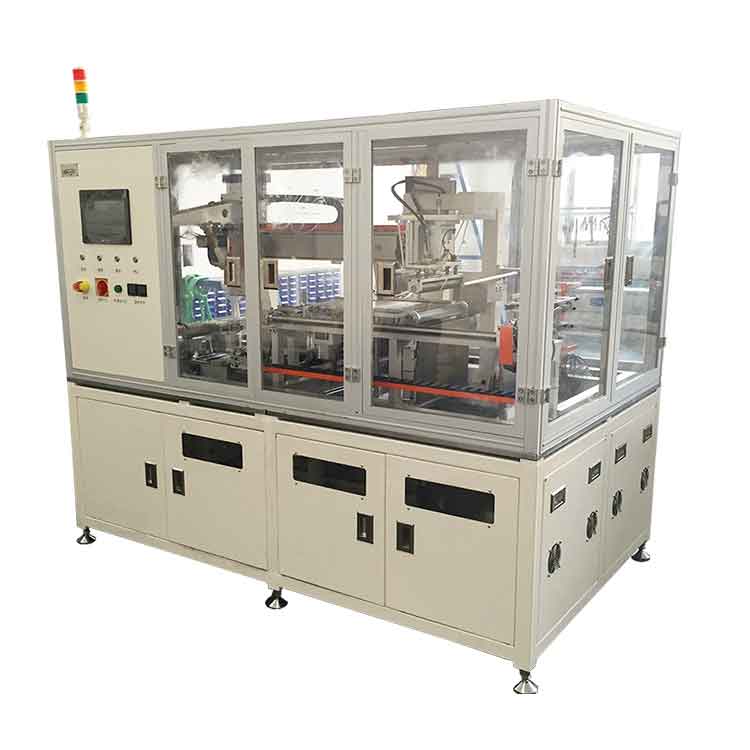

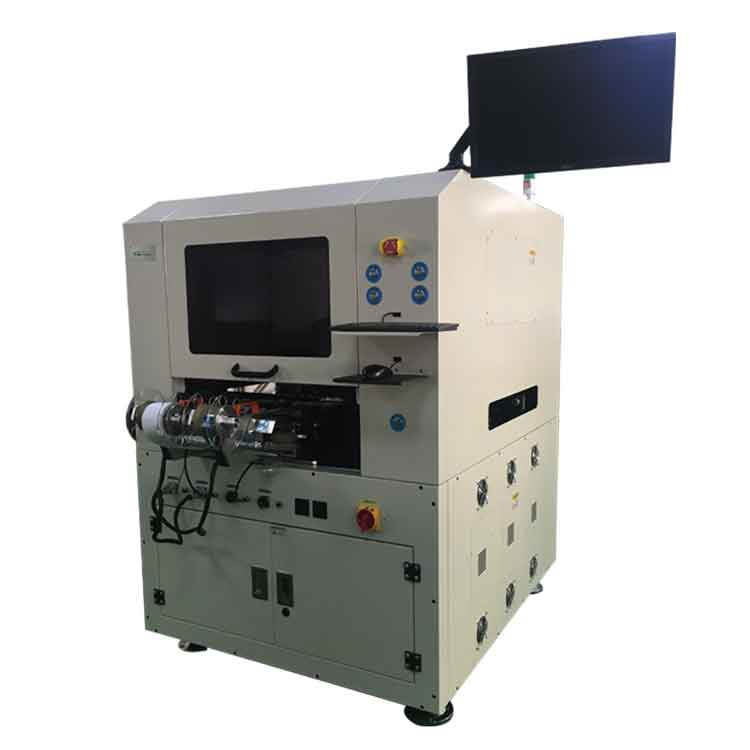
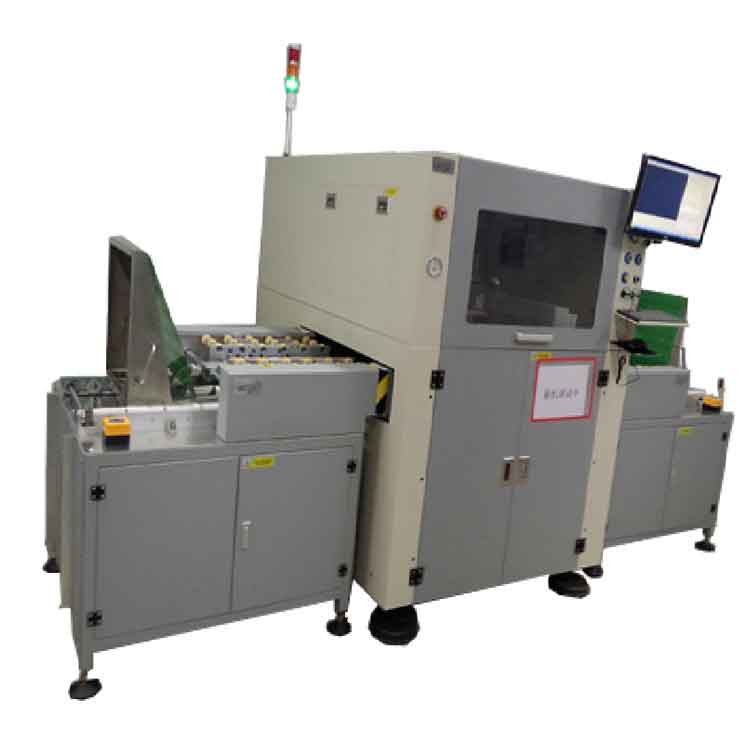



 扫码添加微信
扫码添加微信